SiP被遗忘几十年,只因摩尔定律走不下去才回归大众视线
从苹果第一次公开宣布在iwhach智能手表中采用SiP技术,SiP受关注程度日益提升,甚至被认为是“拯救”摩尔定律的正解之一。
SiP与近亲SoC
业内认为摩尔定律继续有两条可行之路:一条是按照摩尔定律往下发展,CPU、内存、逻辑器件等将是这条路径的主导者与践行者,这些产品占据了市场的50%;另一外是超越摩尔定律的MorethanMoore路线,模拟/RF器件,无源器件、电源管理器件等,从一味追求功耗下降、性能提升,转向更加务实的满足市场需求。
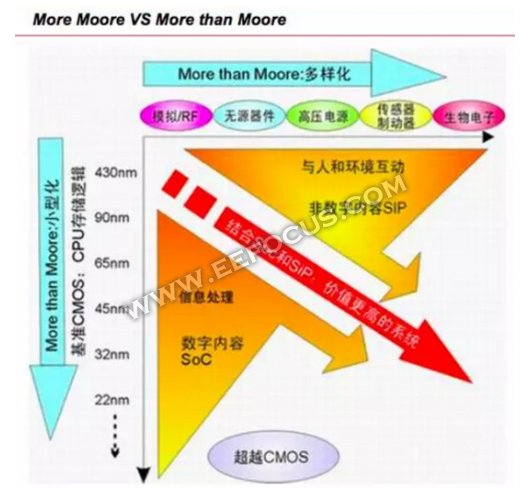
针对这两条路径,分别诞生了两种产品:SoC与SiP。
SoC(SystemOnaChip系统级芯片)是从设计的角度出发,是将系统所需的组件高度集成到一块芯片上。
SiP(SystemInaPackage系统级封装)是从封装的立场出发,对不同芯片进行并排或叠加的封装方式,将多个具有不同功能的有源电子元件与可选无源器件,以及诸如MEMS或者光学器件等其他器件优先组装到一起,实现一定功能的单个标准封装件,形成一个系统或者子系统。
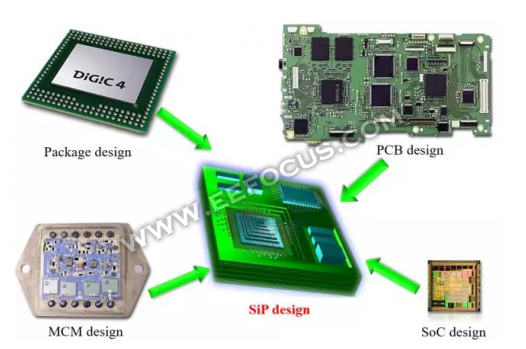
当然,要谈及SoC与SiP两者的竞争关系,较理性的说法就是“互为补充”,SoC主要应用于更新换代较慢的产品和军事装备要求高性能的产品,SiP主要用于换代周期较短的消费类产品,如手机等。SiP在消费领域炙手可热的主要原因之一就是可集成各种无源元件。一部手机中,无源器件与有源器件的比例高于50:1,SiP可以为数量众多的无源器件找到合适的“归宿”。

对于高度集成的SoC而言,在一个芯片上实现数字、模拟、RF等功能,工艺兼容成为一大难题。而SiP却可在实现高度集成的情况下,规避掉这一问题。
从封装发展的角度来看,SiP是SOC封装实现的基础;从集成度角度出发,SoC只集成AP之类的逻辑系统,我们可以将SiP理解为SoC的替代方案,两者的关系可以用一个简单的公式表示:
SiP=SoC+DDR+eMMC+……
SiP的昨天、今天与明天
美国是率先开始系统级封装研究的国家,其前身是早在上世纪就开始为数据存储和特定的军事/航空航天电子设备研发的MCM(多芯片模块)。但由于摩尔定律不断向前发展,可实现更便宜和更轻松地将所有东西放置于一块芯片上,所以这种封装方案被没有得到大范围的采用。而如今,摩尔定律走到了瓶颈期,SiP再次被重视起来。
最早商业化的SiP模块电路是手机中的功率放大器,这类模块中可集成多频功放、功率控制及收发转换开关等功能。SiP模块广泛应用于无线通讯、汽车电子、医疗电子、计算机、军用电子等领域,无线通信领域的应用是最早的,也是最广泛的。
Applewatch的内部的S1模组,就是典型的SiP模块。它将AP、BB、WiFi、Bluetooth、PMU、MEMS等功能芯片以及电阻、电容、电感、巴伦、滤波器等被动器件都集成在一个封装内部,形成一个完整的系统。

有一点值得注意,PCB板并不遵从摩尔定律,是整个系统性能提升的瓶颈。PCB技术发展到今天,布线密度难以提高,器件组装难度也日益加大,互联长度及器件封装引脚的寄生效应都影响着系统性能的进一步提升。由于具备相似的设计思路和特点,SiP技术自然成为高端PCB的最佳替代。目前,很多系统应用已经开始应用SiP技术部分或者全部取代原有的PCB。
SiP改变了PCB作为承载芯片连接之间的载体这一成不变的定义。
SiP封装技术主要优势:
-将不同用途的集成电路芯片以集成电路封装手段进行整合,可将原有的电子电路减少70%~80%以上,整体硬件平台的运行功耗也会因为PCB电路板缩小而减少。产品在整体功耗、体积等方面获得改善;
-将原本离散的功能设计或元件整合在单一芯片内,不仅可以避免设计方案被抄袭复制,也能透过多功能芯片整合的优势让最终产品更具市场竞争力。
封装效率高、产品上市周期短、兼容性好、降低系统成本、物理尺寸小、电性能高、低功耗、稳定性好、应用广泛,这叫各产业如何无法抗拒SiP的诱惑?

SiP技术是多年来一直存在的技术之延伸。奠基于现有如倒装芯片flipchip、晶圆凸块waferbumping、引线接合wirebonding和扇形晶圆级封装fan-outwafer-levelpackaging等的封装技术。甚至可以这样理解:FOWLP在面积扩展的同时也加了有源或无源器件以形成SiP。
SiP的主流封装形式是BGA,但这并不是说具备传统先进封装技术就掌握了SiP技术。
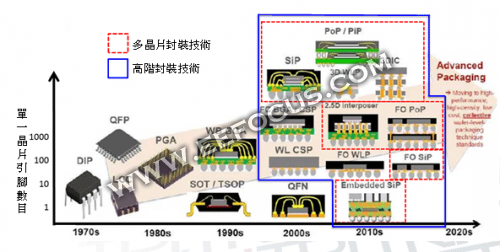
SiP封装技术采取多种裸芯片或模块进行排列组装,若就排列方式进行区分可大体分为平面式2D封装和3D封装的结构。相对于2D封装,采用堆叠的3D封装技术又可以增加使用晶圆或模块的数量,从而在垂直方向上增加了可放置晶圆的层数,进一步增强SIP技术的功能整合能力。而内部接合技术可以是单纯的线键合(WireBonding),也可使用覆晶接合(FlipChip),也可二者混用。除了2D与3D的封装结构外,还可以采用多功能性基板整合组件的方式。不同的芯片排列方式,与不同的内部接合技术搭配,使SIP的封装形态产生多样化的组合,并可依照客户或产品的需求加以客制化或弹性生产。
不过,SiP在合格率与计算机辅助设计方面尚有待进一步提高。
据预计,SiP在智能手机中的渗透率将从2016年的10%迅速提升到2018年的40%。

先进封装是摩尔定律的重要助推力,对于企业而言,先进封装也是封装业的产值提升的一大利器。目前全世界封装的产值只占积体电路总值的10%左右,若SiP从热们到主流,这一占比必将提高,封装业产值必将出现一定幅度的提高,很可能将打破目前积体电路的产业格局。
手机中使用SiP的颗数也在逐渐增多;SiP在无线通信领域的应用最早,也是应用最为广泛的领域;汽车电子是SiP的重要应用场景,发动机控制单元(ECU)、汽车防抱死系统(ABS)、燃油喷射控制系统、安全气囊电子系统、方向盘控制系统、轮胎低气压报警系统等SiP应用正在逐渐增加;SiP在计算机领域的应用主要来自于将处理器和存储器集成在一起……

图片新闻
最新活动更多
-
11月28日立即报名>>> 2024工程师系列—工业电子技术在线会议
-
11月29日立即预约>> 【上海线下】设计,易如反掌—Creo 11发布巡展
-
11月30日立即试用>> 【有奖试用】爱德克IDEC-九大王牌安全产品
-
即日-12.5立即观看>> 松下新能源中国布局:锂一次电池新品介绍
-
12月19日立即报名>> 【线下会议】OFweek 2024(第九届)物联网产业大会
-
即日-12.26火热报名中>> OFweek2024中国智造CIO在线峰会









 分享
分享















发表评论
请输入评论内容...
请输入评论/评论长度6~500个字
暂无评论
暂无评论