电子微组装技术难点如何解决?
随着小型化、轻量级、高工作频率、高可靠性的电子产品不断占据消费市场,电子元器件也逐步进入了高密度、高功能、微型化、多引脚、狭间距的发展阶段,对微组装技术的要求越来越高。
电子微组装技术就是在这样的趋势下,高速发展起来的一种新型电子组装和封装技术。

什么是微组装技术(micro-assembly bonding)
结合各类先进制造领域的定义和观点来看,微组装技术主要由表面贴装(SMT)、混合集成电路(HIC)技术和多芯片模块(MCM)技术组成。
通常来讲,微组装技术综合运用高密度多层基板技术、多芯片组装技术、三维立体组装技术和系统级组装技术等先进手段,在高密度多层互联的电路板上,把微小型电子元器件组装成高密度、高速度、高可靠性立体结构的电子产品,可理解为高密度电子装联技术。
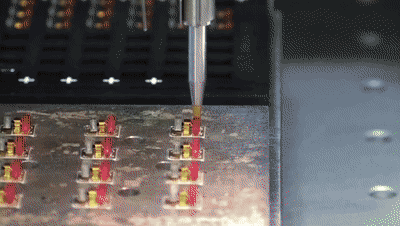
电子微组装涉及的产品非常丰富,包括:分立电子元器件、混合集成电路、多芯片组件、板级组件、微波组件、SiP、微系统、真空电子器件等。
目前,电子微组装技术已在Micro LED/Mini LED显示芯片、手机微型元器件、MEMS器件、射频器件、微波器件和混合电路等领域得到广泛应用,已成为电子先进制造技术水平的重要标志之一。
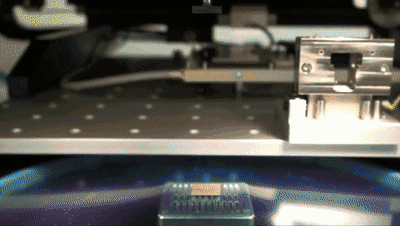
微组装设备的核心工艺-贴片
微组装设备是集光、机、电为一体的自动化设备,利用加压、加热、超声等方式完成芯片与基板之间的引线键合焊接过程,微组装工艺对贴装精度的要求非常高,因而高精密贴装焊头起着非常关键的作用。
由于元器件的组装密度高,而且组装材料既是结构的固定材料,又是电路的阻/容/感元件,有很多复杂的元件和超小型器件,对贴装精度和对位角度精度有较高的要求。

另外,这些元件又存在易碎易变性的特点,所以在贴装的过程中使用精准的压力控制来保证元件的安全拾取也至关重要。
特别是微组装中MEMS器件表面通常会有各种裸露的功能性结构,如何精准的定位元件表面拾取吸附位置和控制拾取贴装的压力,成为了贴装工艺中的难点和重点。

精细可控的键合压力,降低损耗
国奥直线旋转电机带有“软着陆”功能,可实现±1.5g以内的稳定力度控制,支持速度、加速度及力度控制的程序化设定,使贴装头能够以非常轻的压力触碰元件,降低损耗。
突破式Z轴设计,提升速度
采用一体化高度集成设计,将传统“伺服马达+滚珠丝杆”合二为一,解决了Z轴自重负载问题,减轻机身重量也节省了设备内部空间,大幅提升贴片速度。
高精度对位、贴片,保证良率
±0.01N的力控精度,±2μm直线重复定位精度,±0.01°旋转重复定位精度,可在高速运行状态下仍稳定输出,保证生产良率。

随着电子微组装技术的高速拓展,半导体技术、封装技术和系统级封装产品之间的界限已经越来越模糊,其发展的方向也趋于一致,即朝着高密度、高精度、多功能、立体化、智能化的趋势发展。
电子微组装设备厂商也只有敏锐把握行业发展的脉络,加速提升设备的精度和生产的良率,才能在激烈的市场竞争中占据先机。诚邀您与国奥电机合作,开启互利共赢。

图片新闻
技术文库
最新活动更多
-
即日-12.26立即报名>>> 【在线会议】村田用于AR/VR设计开发解决方案
-
1月8日火热报名中>> Allegro助力汽车电气化和底盘解决方案优化在线研讨会
-
1月9日立即预约>>> 【直播】ADI电能计量方案:新一代直流表、EV充电器和S级电能表
-
即日-1.14火热报名中>> OFweek2025中国智造CIO在线峰会
-
即日-1.16立即报名>>> 【在线会议】ImSym 开启全流程成像仿真时代
-
即日-1.20限时下载>>> 爱德克(IDEC)设备及工业现场安全解决方案
推荐专题









 分享
分享















发表评论
请输入评论内容...
请输入评论/评论长度6~500个字
暂无评论
暂无评论