电子产品无Pb制程的工艺可靠性问题
一、概述
随着电子信息产业的日新月异,微细间距器件发展起来,组装密度越来越高,诞生了新型SMT、MCM技术,如图1所示。
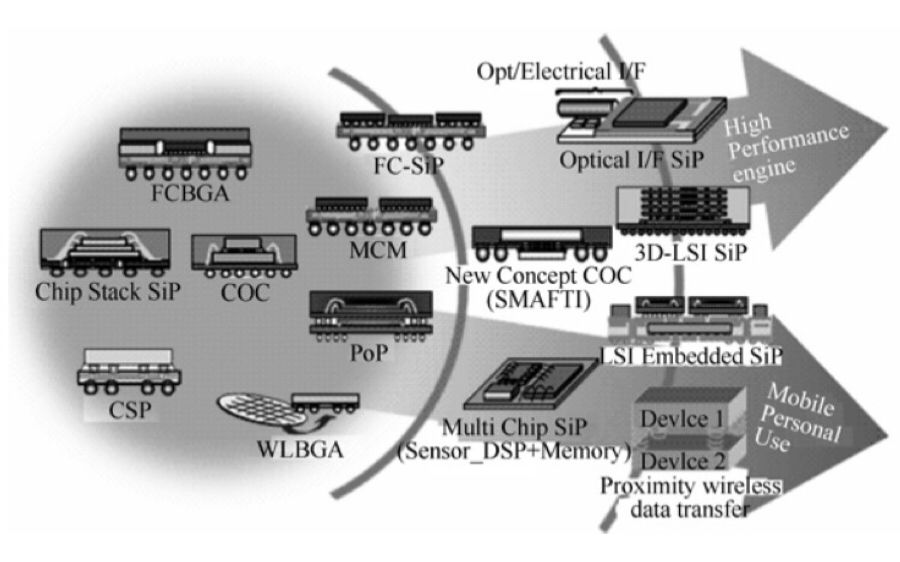
图1 微电子学芯片封装技术的发展
现在微电子器件中的焊点越来越小,但其所承载的力学、电学和热力学负荷却越来越重,对可靠性的要求也日益增高。电子封装中广泛采用的SMT封装技术及新型的芯片尺寸封装(CSP)、钎料球阵列(BGA)等封装技术均要求通过焊点直接实现异材间电气及刚性机械连接(主要承受剪切应变),它的质量与可靠性决定了电子产品的质量。
一个焊点的失效就有可能造成器件整体的失效,因此如何保证焊点的质量是一个重要问题。传统SnPb钎料含Pb,而Pb及Pb化合物属剧毒物质,长期使用含Pb钎料会给人类健康和生活环境带来严重危害。目前电子行业对无Pb焊接的需求越来越迫切,已经对整个行业形成巨大冲击。无Pb钎料已经逐步取代有Pb钎料,但无Pb化制程由于钎料的差异和焊接工艺参数的调整,必不可少地会给焊点可靠性带来新的问题。因此,无Pb焊点的可靠性也越来越受到重视。
二、无Pb制程定义及系统考虑
(1)无Pb制程定义RoHS中规定禁止使用铅(Pb)、汞(Hg)、镉(Cd)、六价铬(Cr6+)、多溴联苯(PBB)、多溴二苯醚(PBDE)6种有害物质,实施日期是2006年7月1日。这意味着,从这天起,所有的EEE(电气、电子设备),那些豁免的除外,一旦它们含有这6种禁用物质,就不能在欧盟市场上销售。无一禁用物(如无Pb)的定义是什么?这6种禁用物质在任何一个EEE的均匀材质中所允许的最大浓度值(MCV)已在EU公报上公布,并在2005 年8月18日立法。
条款5(1)(a)规定,铅、汞、六价铬、多溴联苯(PBB)、多溴二苯醚(PBDE)均匀材质的MCV 均为0.1wt%,镉的MCV为0.01wt%。简单地讲,以无Pb为例,定义为任何一个EEE在所有的(单个的)均匀材质中,Pb含量小于0.1wt%。
(2)无Pb制程的系统考虑电子产品无Pb制程取代目前的有Pb工艺,已是大势所趋。它正从研发走向产业化,从小批试产走向大规模量产,从消费类产品扩大到绝大多数的产品类型,兼容成为一个关键问题。在无Pb制程中,不管可靠性是否达到在苛刻环境中使用的电子产品的要求,都是必须关注的。苛刻环境的定义是:凡是必须长时间在温度大幅度升高、持续承受很大负载、温度剧烈变化、特别高的温度、很强的机械撞击或振动、腐蚀性等环境中工作的产品,或者同时要在上述几种情况或者所有情况下使用的产品,均属于“在苛刻环境下使用的电子产品”范畴。进一步讲,由于电路设计方面的局限性,焊点两边的热膨胀系数严重失配,也可以列入苛刻环境的范畴。从有Pb焊接过程到无Pb焊接的系统性考虑,包括设计、材料、工艺、质量,以及可靠性、设备、操作和商业化等多方面,而无Pb钎料的系统连接可靠性则是无Pb转换的关键。无Pb焊接的系统考虑如图2所示。

图2 无Pb焊接的系统考虑
三、电子产品无Pb制程工艺可靠性理解
电子产品无Pb制程是怎样影响到产品性能和工艺控制的,这是其执行的核心内容。从富Pb材料切换到无Pb材料时,失效模式和效果分析(FMEA)是有差异的。从机械角度看,典型的无Pb材料要比含Pb高的材料硬。硬度对插座设计、电气接触(阻抗和接触电阻)及整个焊点均有影响。不仅无Pb合金具有较硬的特点,就连表面氧化物、助焊剂残留物、合金污染物等残留覆盖物组合,也能在电气接触和接触电阻上产生多种影响。因此,电子产品从富Pb向无Pb制程的转换,在电气或机械方面都不是一个普通的替换。当比较无Pb和富Pb钎料时,由于尺寸的变化,在倒装芯片的钎料球和μBGA封装间会产生持久性的变化。
Pb是比较软的容易变形,因此无Pb制程的焊点硬度比有Pb的高,强度好些,变形也小些。但这一切并不等于无Pb制程焊点的可靠性好,由于无Pb钎料的润湿性差,空洞、移位、立碑等焊接缺陷比较多。由于熔点高,如果助焊剂的活化温度不能配合高熔点的较高温度和较长时间的助焊剂浸润区的话,就会使焊接面在高温下重新氧化而不能发生浸润和扩散效果,不能形成良好的界面合金层,其结果是导致焊点界面结合强度(抗拉强度)差而降低可靠性。
四、影响电子产品无Pb制程工艺可靠性的因素
无Pb焊点的可靠性问题主要来源于:
●焊点的剪切疲劳与蠕变裂纹;
●电迁移、钎料与基体金属界面金属间化合物形成裂纹;
●Sn晶须生长引起短路;
●电腐蚀和化学腐蚀问题。无Pb焊接工艺可靠性是一个非常复杂的工程问题,归纳起来主要取决于工艺可靠性设计、工艺操作规范及工艺管理等诸多因素,如图3所示。

图3 影响无Pb焊点工艺可靠性的因素
与传统的有Pb工艺相比,无Pb化焊接由于钎料的差异和工艺参数的调整,必不可少地会给焊点可靠性带来一定的影响。首先是无Pb钎料的熔点较高。传统的Sn37Pb共晶钎料熔点是183℃,而共晶无Pb钎料(SAC387)的熔点为217℃,温度曲线的提升随之带来的是钎料易氧化,金属间化合物生长迅速等问题。其次,由于无Pb钎料不含Pb,润湿性差,容易导致产品焊点的自校准能力、拉伸强度、剪切强度等不能满足要求。以某OEM公司为例,原含Pb工艺焊点不合格率平均在50ppm左右,而无Pb制程由于钎料润湿性差,不合格率上升至200~500ppm。
与传统的含Pb工艺相同,影响无Pb工艺焊点可靠性的因素也可以大致分为下述几个方面。
1.钎料合金的影响钎料合金的选择极为重要。目前,大多采用SAC合金系列,液相温度是217~227℃,这就要求再流焊具有较高的峰值温度,如前所述会带来钎料及导体材料(如Cu箔)易高温氧化,金属间化合物生长迅速等问题。因为在焊接过程中,熔融的钎料与焊接衬底接触时,由于高温在界面会形成一层金属间化合物(IMC)。其形成不但受再流焊接温度、时间的控制,而且在后期使用过程中其厚度还会随时间而增加。
界面上的IMC是影响焊点可靠性的一个关键因素。过厚的IMC层的存在会导致焊点断裂、韧性和抗低周期疲劳能力下降,从而导致焊点的可靠性降低。无Pb钎料中Sn含量都比SnPb钎料高,这更增大了焊点和基体金属间界面上形成IMC的速率,导致焊点提前失效。
另外,由于无Pb钎料和传统SnPb钎料成分不同,因而它们和焊盘材料,如Cu、Ni、Ag、Pd等的反应速率及反应产物也可能不同,焊点也会表现出不同的可靠性。同时钎料和助焊剂的兼容性也会对焊点的可靠性产生非常大的影响,有研究表明:钎料和助焊剂各成分之间不兼容会导致附着力减小。此外,由于热膨胀系数(CTE)不匹配,又会加快钎料周期性的疲劳失效。
因此,要特别注意选择兼容性优良的钎料和助焊剂,才能承受住无Pb再流焊时的高温冲击。
●目前有Pb钎料合金大都使用的是Sn37Pb,熔点为183℃。
●目前业界无Pb制程再流焊接中“主流”钎料合金是SAC,其中应用最广的成分是SAC305和SAC387(共晶组分),前者熔化温度范围为217~220℃,后者为共晶组分,熔点为217℃,而波峰焊接则可能是SAC305或Sn0.7Cu(x)(熔点为227℃)。SAC合金和SnCu(x)合金拥有不同的可靠性特性。由上可知,无Pb共晶组分SAC387比有Pb共晶组分Sn37Pb合金的熔点要高出34℃。
显然,从有Pb焊接转变到无Pb焊接并不仅仅是单纯的材料代换而已,它还带来了许多可靠性方面的困扰。微电子领域使用的钎料有着很严格的性能要求,无Pb钎料(以SAC为例)也不例外,不仅包括电学和力学性能,还必须具有理想的熔融温度。从制造工艺和可靠性两方面考虑,表1列出了钎料合金的一些重要性能。表1 钎料合金的重要性能

2.元器件影响元器件可靠性的因素如下。
(1)高温影响。某些元器件,如塑料封装的元器件、电解电容器等,受高的焊接温度的影响程度要超过其他因素。
(2)Sn晶须的影响。Sn晶须是长寿命的高端产品中精细间距元器件更加需要关注的另一个问题。无Pb钎料合金均属高Sn合金,长Sn晶须的概率比SnPb高得多。通过限制Sn层厚度来限制晶须的最终长度并不实际。人们普遍相信添加3wt%或更多Pb可防止晶须的形成,并且这种现象很少在SnPb焊点上发生。虽然偶尔观察到SnPb钎料中长出长达25~30μm的晶须,但可能是在大电流下电迁移效应导致的异常析出现象。
(3)应力的影响。SAC合金也会给元器件带来更大的应力,使低k介电系数的元器件更易失效。
(4)焊端表面镀层的影响。无Pb元器件焊端表面镀层的种类很多,有镀纯Sn和SAC的,也有镀SnCu、SnBi等合金的。镀Sn的成本比较低,因此采用镀Sn工艺比较多。但由于Sn表面容易氧化形成很薄的氧化层,加上电镀后易产生应力形成Sn晶须。Sn晶须在窄间距的器件QFP等容易造成短路,影响可靠性。故对于低端产品及寿命要求小于5年的元器件可以镀纯Sn。而对于高可靠产品及寿命要求大于5年的元器件,则应先镀一层厚度为1μm以上的Ni,然后再镀2~3μm厚的Sn。
(5)零部件的供应质量问题。由于各部件均来自于不同厂商,因而部件质量难免参差不齐,如器件引脚可焊性不足等。由于以前的热风整平(HASL)焊盘涂层工艺存在缺点,如今的OEM厂商应用较广泛的包括有机可焊性保护层(OSP)等涂层工艺。
3.PCB
(1)基材某些PCB(特别是大型复杂的厚PCB)根据层压材料的属性,可能会由于无Pb焊接温度较高而导致分层、层压破裂、Cu裂缝、CAF(导电阳极丝)等失效故障率上升。它还取决于PCB表面涂层,例如钎料与Ni层(ENIG涂层)之间的接合要比钎料与Cu(如OSP和浸银)之间的接合更易断裂,特别是在机械撞击下(如跌落测试中)尤为明显。
(2)焊盘涂层表面处理的最主要作用就是确保金属基底(通常是铜)的可焊性。由于以前的热风整平(HASL)焊盘涂层工艺存在缺点,可替代的表面涂层包括:有机可焊性保护膜(OSP)、Ni/Au、Ni/Pd/Au、Im-Sn和Im-Ag等。其中Ni/Au涂层又有ENIG Ni/Au和EG Ni/Au两种。无论选择哪种表面处理,它都必须维持精确的信号完整性,确保在任何情况下信号完整性都不会下降。选择正确的镀层还需要考虑的问题包括:电磁兼容(EMI)、接触电阻和焊点的强度。最后使用的表面处理要有利于控制电磁干扰。它还不能因为时间长而降低性能,否则在表面处理层/焊盘的连接部位会出现泄漏造成电磁干扰的问题。EG Ni/Au和ENIG Ni/Au都存在明显的可靠性问题,SnPb焊点在EG Ni/Au焊盘上的接合强度在使用几年后就可能大幅下降。由于无法对Au镀层的厚度实施有效且一致的控制,因此,建议在SnPb焊接中不采用Ni/Au的焊盘。
(3)PCB厚度的影响相同封装安装到不同厚度的PCB上的温度循环结果是:在使用的条件范围内,较薄的PCB拥有较长的温度循环寿命。事实上,厚PCB更难使得封装的热膨胀和收缩相一致,因此在焊点处导致了较大的热应力。4)焊盘定义对焊点可靠性的影响相同封装分别采用NSMD和SMD焊盘定义,如图4所示。以纯有Pb情况为例,将元器件连接到PCB上后,焊点的可靠性是不一样的。在循环温度范围为-40~125℃/10min的条件下,其寿命F(t)的威布尔分布如图5所示。
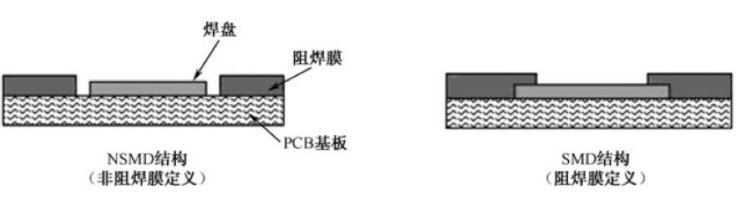
图4
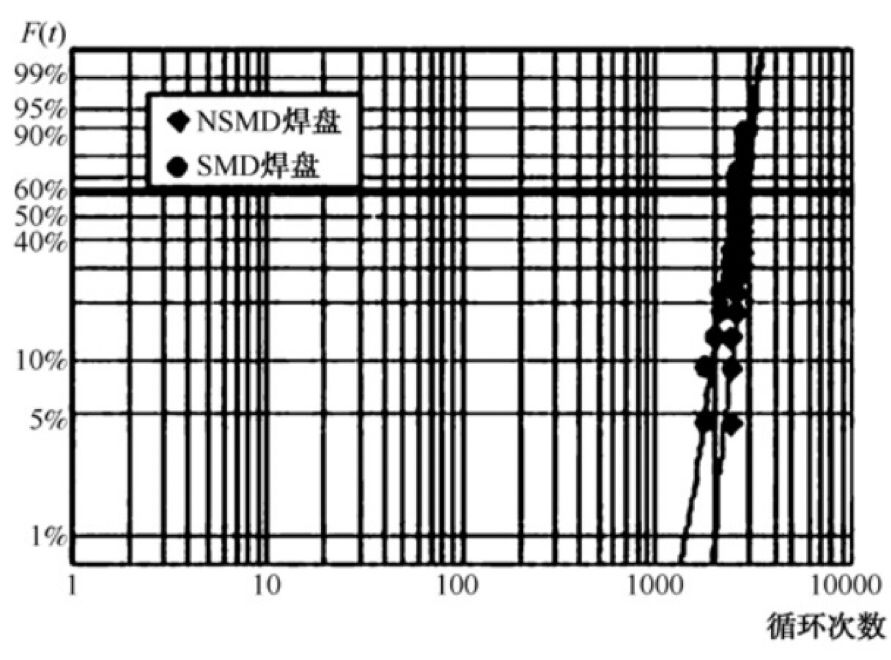
图5 NSMD/SMD焊点
在高低温温度循环试验中F(t)的威布尔分布图NSMD结构比SMD结构拥有较长的温度循环寿命。当采用NSMD结构时,焊接的连接力较大的原因是:焊盘的连接面积扩展到焊盘的侧面了。
(5)单面焊接和双面焊接存在的可靠性差异进行单面焊接和双面焊接转换安装(如表2所示)的结果,以及随后的温度循环特性比较,如图6、图7所示。即封装安装在底部面上时,就相当于被同样宽度大小的焊盘所替换,其温度循环特性几乎和单面焊接相同。表2 双面焊接验证
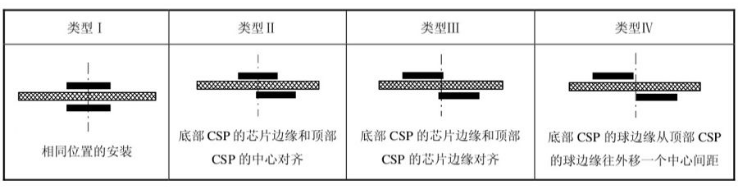

图6 安装形式Ⅰ~Ⅳ在温度循环中的威布尔分布图(以有Pb为例)

图7 单面和双面安装在温度循环试验中的威布尔分布(以有Pb为例)

图片新闻
技术文库
最新活动更多
-
即日-12.26立即报名>>> 【在线会议】村田用于AR/VR设计开发解决方案
-
1月8日火热报名中>> Allegro助力汽车电气化和底盘解决方案优化在线研讨会
-
1月9日立即预约>>> 【直播】ADI电能计量方案:新一代直流表、EV充电器和S级电能表
-
即日-1.16立即报名>>> 【在线会议】ImSym 开启全流程成像仿真时代
-
即日-1.20限时下载>>> 爱德克(IDEC)设备及工业现场安全解决方案
-
即日-1.24立即参与>>> 【限时免费】安森美:Treo 平台带来出色的精密模拟
推荐专题









 分享
分享















发表评论
请输入评论内容...
请输入评论/评论长度6~500个字
暂无评论
暂无评论