4日10日 OFweek 2025(第十四届)中国机器人产业大会
立即报名 >>>
7.30-8.1 全数会2025(第六届)机器人及智能工厂展
火热报名中>>
氮化镓 | 利用反向击穿对p-GaN活化性能进行评估,以作为“电力电子应用中的敏感探针”
美国康奈尔大学,IQE RF LLC和Qorvo公司一直在研究如何更好地将埋入式p型GaN层活化 [Wenshen Li et al, Appl. Phys. Lett., vol113, p062105, p2018]。在大多数GaN / III-N生长过程中,p型层由于难以活化而留在最后,这通常涉及到通过加热样品以试图驱除样品内部的氢,从而钝化用于产生移动空穴载流子的镁的掺杂。
这种p-GaN-last约束限制的结构可以用于电力电子和其他应用的研究。埋入式结构器件有包括异质结双极晶体管(HBT),沟槽金属氧化物半导体场效应晶体管(MOSFET),电流孔径垂直电子晶体管(CAVET)和横向扩散MOSFET (LDMOSFET)。
如图1,金属有机化学气相沉积(MOCVD)在块状GaN上产生外延层。顶部p-GaN层在原位发生活化。研究人员说,接触电阻(~4x10-5Ω-cm2)和霍尔测量(空穴密度~7%镁浓度,迁移率为24cm2/Vs)会使这种具有顶部p-GaN层的材料的性能最优。
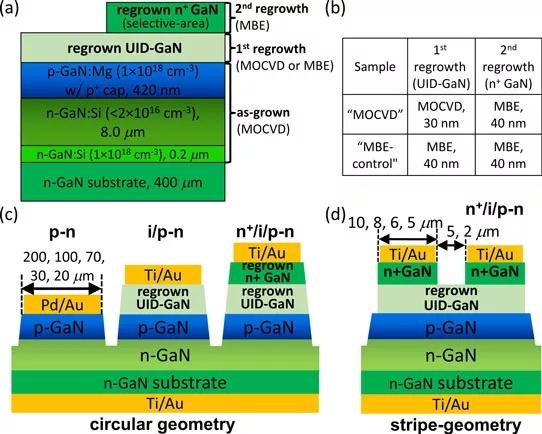
图1:(a)原生长的原位活化p-n二极管结构和两个再生长层的示意层结构。(b)MOCVD和MBE对照样品上两个再生长层的信息表。(c)三种类型的圆形二极管的示意性横截面:在两个样品上合成的p-n,i/p-n和n+/ i /p-n二极管。(d)具有条纹几何形状的n+/ i /p-n二极管的示意性横截面。 条纹长度50微米。
然后通过毯式MOCVD或未掺杂GaN的分子束外延(MBE)再生长来掩埋p型GaN。对于MOCVD样品,将p型GaN 在反应室中在900℃的氨气氛围中退火钝化30分钟,并将其用紫外 - 臭氧和氢氟酸进行处理,降低MOCVD样品中硅的残留。 对于MBE样品,掩埋的p型GaN是未钝化的。 通过MBE在两个样品上选择性地生长,最终确定n+型GaN层。
该材料所产生的这种埋入式p-GaN结构,用于各种叠层的钯(Pd),钛(Ti)和金(Au)的触点进行电测试。 利用干刻蚀法来去除未掺杂的GaN中再生顶层并用于台面隔离。并且将p型GaN在干燥空气氛围中在725℃下退火30分钟来进行活化,利用台面侧壁来去除内部的氢。退火后,材料的金属触点被施加上。
我们发现,在埋入式p型GaN在没有被活化的情况下,未金属化的MOCVD-样品结构在反向偏压下显示出高漏电流,而经过火化后,可以抑制电流的高漏。
由图2可以得知,对于退火后的圆形p-n和i / p-n二极管,其反向偏压击穿是在1100-1200V范围内的这与直径无关。同时我们观察到击穿损坏作为台面边缘处的燃烧区域,对于没有场板或其他边缘终端结构的装置而言是典型的问题。研究人员估计,p型GaN层中镁受体的活化超过28%,这是根据穿通时的场分布计算得出的。

图2:反向和正向电流密度与二极管的电压特性。(a)MOCVD上圆形二极管的反向偏压特性;(b)MBE控制样品上的反向偏压特性;(c)在MOCVD样品上具有条纹形状时的n+/i/p-n二极管的反向偏压特性;(d)MOCVD样品上各种二极管的正向偏压特性。
由图可以看出,n+/i/p-n二极管具有更高的电度,并且在300V时发生与电流相关的软击穿。 MBE样品装置具有低得多的电流密度,这归因于再生层中的氢去除。
n+/i/p-n二极管中的高电流密度归因于n+ 型GaN层阻挡住氢从掩埋的p型GaN层中扩散。 对于i / p-n器件,镁扩散到未掺杂(UID)GaN帽中将其转换为p-GaN层,并允许氢在活化期间向上扩散。 但即使使用直径为20μm的圆形器件,氢气通过台面侧壁的扩散也不足以进行有效的p-GaN活化。
宽度在10μm和5μm之间的窄条纹器件降低了漏电流,并使击穿值达到与圆形p-n和i / p-n二极管相当的程度。 研究人员说:“这些数据表明,在这项工作中,在退火条件下,埋入的p型GaN能够充分活化,因此横向氢扩散长度>5μm(条纹宽度的一半)。而活化则是由于氢从蚀刻的台面侧壁以及条纹之间暴露的UID-GaN表面的横向扩散造成的。
p-n和i / p-n圆形器件的正向偏置特性相似 - 由于与p型GaN的欧姆接触不良,导通电压相当高,导通电流低。
n+ / i / p-n器件是背对背二极管,因此在“正向”偏压区域不具备高电流。 圆形n+ / i / p-n二极管的高电流密度表现出高泄漏电压并因此表现出较差的p-GaN活化状态。而条纹器件中则与之相反,泄露电压被抑制。
研究人员将10-20μm作为通过退火有效活化掩埋p-GaN的临界横向尺寸范围。 该范围允许氢从p-GaN表面逸出,扩散长度为5-10μm。
同时研究人员表示“反向击穿测量是对埋入式p型GaN的受主活化比光发射更严格的测试。 埋入的p型GaN的任何不充分活化都会导致由于过早击穿而导致的电流的急剧增加。
该团队还建议在表面附近活化镁会产生吸引氢离子(主要是质子)的电场,从而增强向外扩散。 然而,当需要氢扩散的横向尺寸增加时,浓度梯度和电场的影响减小。

图片新闻
技术文库
最新活动更多
-
3月27日立即报名>> 【工程师系列】汽车电子技术在线大会
-
4月1日立即下载>> 【村田汽车】汽车E/E架构革新中,新智能座舱挑战的解决方案
-
4日10日立即报名>> OFweek 2025(第十四届)中国机器人产业大会
-
即日-4.22立即报名>> 【在线会议】汽车腐蚀及防护的多物理场仿真
-
4月23日立即报名>> 【在线会议】研华嵌入式核心优势,以Edge AI驱动机器视觉升级
-
4月25日立即报名>> 【线下论坛】新唐科技2025新品发布会
推荐专题
-
1 HBM4大战









 分享
分享




















发表评论
请输入评论内容...
请输入评论/评论长度6~500个字
暂无评论
暂无评论