4日10日 OFweek 2025(第十四届)中国机器人产业大会
立即报名 >>>
7.30-8.1 全数会2025(第六届)机器人及智能工厂展
火热报名中>>
台积电发布三大芯片新技术,我们还能追得上么?
台积电作为全球最牛的芯片制造大厂,不仅技术全球第一,良率也是全球第一。同时市场份额也是全球第一。
而为了保证自己第一的位置不动摇,台积电每年投入研发的费用都是上百亿美元,其它小企业,要想追上台积电,可以说遥遥无期,毕竟很多芯片制造企业,每年的营收都没有100亿美元,怎么能和台积电比?
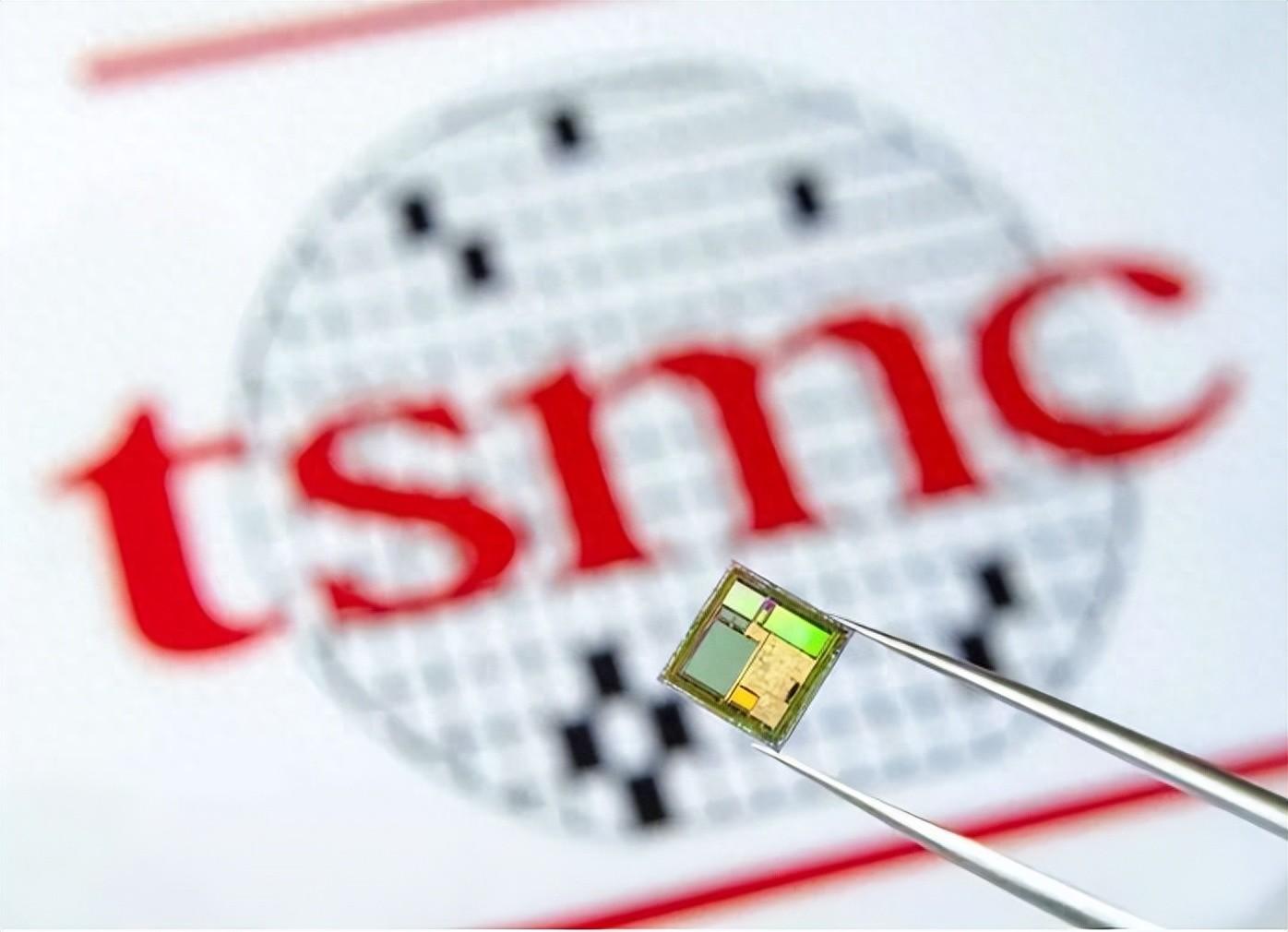
这不,近日台积电在芯片技术上,一口气又发布了三大新技术,再引引领全球。
第一大新技术是光电共封技术。
这个比较容易理解,现在的芯片都是电技术,台积电的新技术,计划将光通信也封装到芯片里面去,成为光电共封装器件 (CPO)。
这种技术有什么用?其实就是让芯片的数据传输更快,因为封装在一块芯片中,减少损耗,还能够降低成本,缩小尺寸,提高性能,降低功耗,促进人工智能和数据中心应用的高速数据传输,预计在2026年量产。
第二大技术叫做背面供电技术。
目前的芯片,均采用前面供电技术,把把电源部署在芯片的正面,这样的弊端是电源会挤占芯片空间,导致功耗、发热没那么好控制。
台积电计划接下来研发背面供电技术,采用新型背底,然后将电源部署在芯片的背面,这样提高芯片的性能、功耗效率和面积利用率。
目前芯片工艺提升越来越慢,成本也越来越高,性能提升也达到极限,背面供电技术,有望很好的在工艺不变的情况下,提高性能,降低功能。

第三大技术则是晶圆级封装技术。
何谓晶圆级封装?即一块晶圆中,封装多种芯片,这些芯片直接在晶圆上互联,有一点类似于小芯片,但却又截然不同的小芯片技术。
而多颗芯片在一块晶圆上时,性能会显著提升,互传损耗会大幅度的减少,当然面积也会增大,也许不适应于手机这样的小空间设备,但在数据中心,AI服务器中,这些设备不那么在乎面积时,就能得到很好的应用。
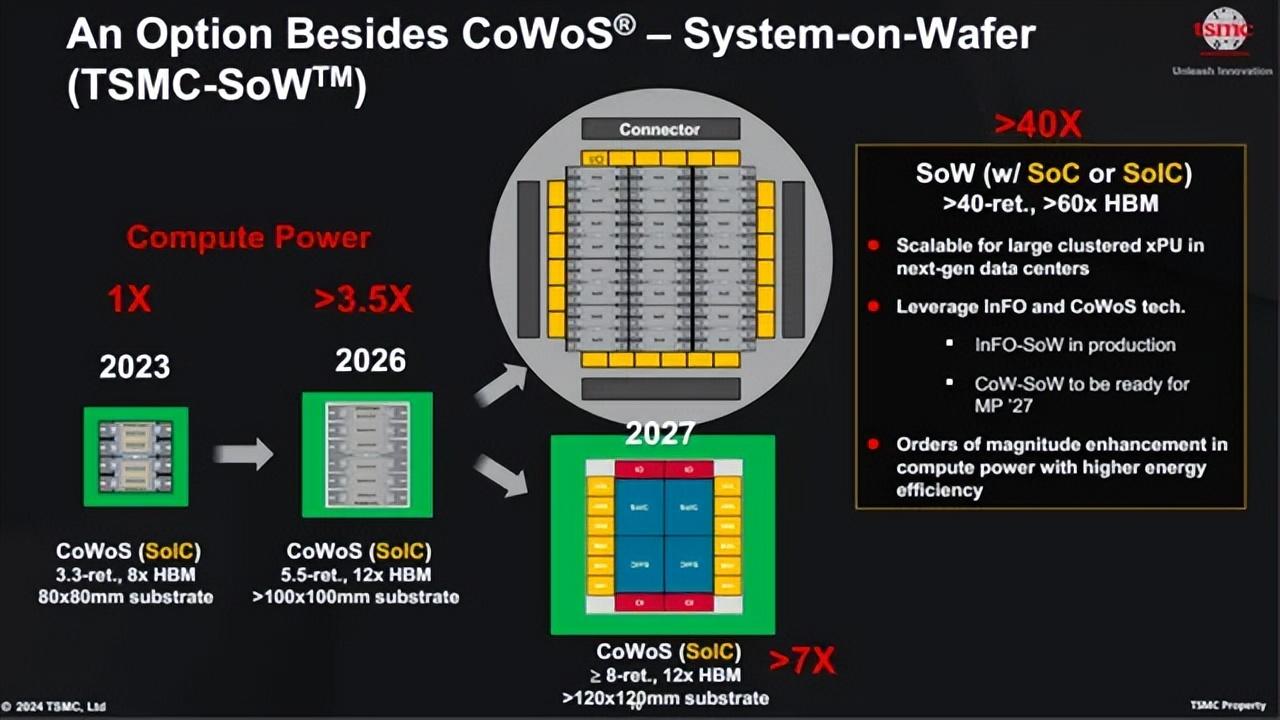
这三大技术,均是依托于先进的制造、封装工艺,全球也就三星、intel有望和台积电掰一掰手腕,其它企业没太多的参与资格。
而我们的芯片产业情况特殊,就算短时间之内,没法追上台积电,但也不得不去研发这些技术,因为我们没有退路,只有往前,要摆脱对外依赖才行。
原文标题 : 台积电发布三大芯片新技术,我们还能追得上么?

图片新闻
技术文库
最新活动更多
-
3月27日立即报名>> 【工程师系列】汽车电子技术在线大会
-
4月1日立即下载>> 【村田汽车】汽车E/E架构革新中,新智能座舱挑战的解决方案
-
4日10日立即报名>> OFweek 2025(第十四届)中国机器人产业大会
-
即日-4.22立即报名>> 【在线会议】汽车腐蚀及防护的多物理场仿真
-
4月25日立即报名>> 【线下论坛】新唐科技2025新品发布会
-
4月30日立即参与 >> 【白皮书】研华机器视觉项目召集令
推荐专题
-
1 HBM4大战









 分享
分享




















发表评论
请输入评论内容...
请输入评论/评论长度6~500个字
暂无评论
暂无评论