7.30-8.1 全数会2025(第六届)机器人及智能工厂展
火热报名中>>
BGA、CSP再流焊接接合部工艺可靠性设计
一、确定必要的钎料量
1.确定必要钎料量(体积)的理论依据滨田正和认为:BGA、CSP再流焊接接合部的结构具有下述3个特征。① 凸形再流焊接接合部,不像QFP那样可以通过外部引线来吸收外部的负荷和应力,BGA、CSP完全靠钎料自身来确保可靠性。② 在BGA、CSP封装内部也有接合部(见图1)。因此,受搭载元器件的PCB基板的挠曲变形的影响大,如图2所示。
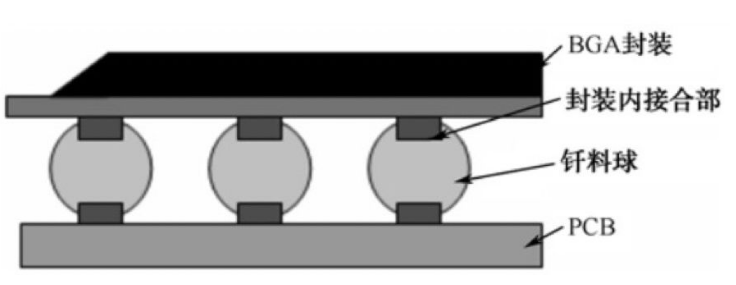
图1 BGA、CSP封装及其接合部
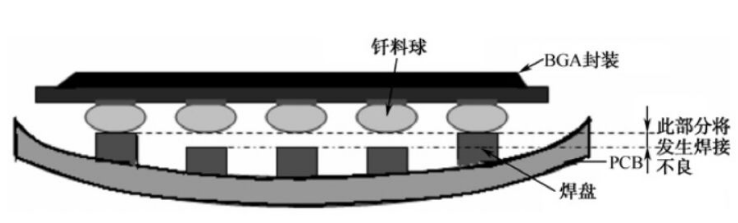
图2基板挠曲变形的影响
③ 钎料球的接合部均是一次成形的。因此,确保接合部良好的润湿性非常重要。并利用焊接中自身的矫正作用(由熔融钎料的表面张力对元器件贴装位置的自动修正效应),来自动修正位置偏差。
为确保BGA、CSP组装的可靠性,根据什么来配置必要的钎料量呢?BGA、CSP焊前定位所需的钎料量是极少的。因此,必需的钎料量主要是根据PCB的挠曲状况来确定。应利用基板挠曲的大小和焊接时沉降量的平衡状态来确定必要的钎料量。沉降现象的发生取决于焊接时接合部熔融钎料的表面张力、钎料球的内压力及封装体的自重综合作用的结果,如图3所示。
沉降现象发生时,对基板挠曲的吸收示意如图4所示。

图3 沉降现象的发生机理
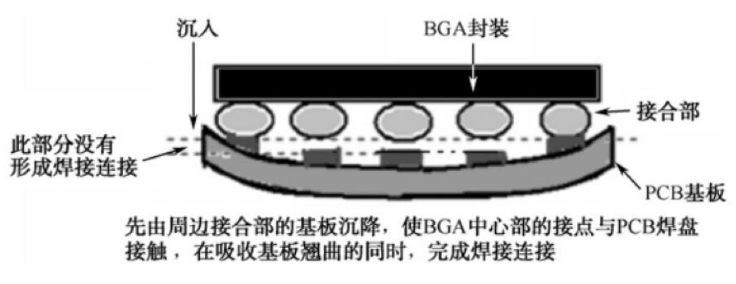
图4 沉降现象对基板挠曲的吸收
2.必要的钎料量(体积)的确定在BGA、CSP等凸点型接合部所有的外来负荷都必须由钎料本身来吸收,如图5所示。
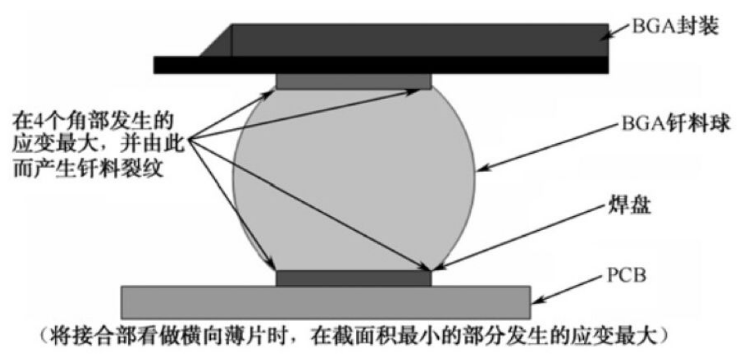
图5 BGA、CSP等凸点型接合部结构特征
通过对基板挠曲和沉降现象的分析,在确定BGA、CSP焊接过程中发生挠曲的吸收所必需的钎料量时,应从下述两方面来分析。1)最小钎料量(体积)Qmin当不发生挠曲变形时,为吸收基板挠曲而设置的钎料量就没有必要了。此时,必要的钎料量只需满足芯片焊前定位和焊接时的润湿性即可。
为定位和润湿焊盘表面,我们设定只要有0.01mm的钎料厚度层即可满足要求。当PCB焊盘半径为r时,可求得最小钎料量为Qmin=πD^2×0.01/4(mm3) (1)2)最大钎料量(体积)Qmax当沉降量不能吸收基板的挠曲时,如陶瓷封装的CBGA、CSP,因为封装不会挠曲,所以基板的挠曲量-BGA、CSP封装的挠曲量的差值变大(基板挠曲量-BGA、CSP封装挠曲量>沉降量)。

图片新闻
技术文库
最新活动更多
-
3月27日立即报名>> 【工程师系列】汽车电子技术在线大会
-
4月25日立即报名>> 【线下论坛】新唐科技2025新品发布会
-
在线会议观看回放>>> AI加速卡中村田的技术创新与趋势探讨
-
4月30日立即参与 >> 【白皮书】研华机器视觉项目召集令
-
即日-5.15立即报名>>> 【在线会议】安森美Hyperlux™ ID系列引领iToF技术革新
-
5月15日立即下载>> 【白皮书】精确和高效地表征3000V/20A功率器件应用指南
推荐专题
-
10 功率半导体,嗅到风险









 分享
分享




















发表评论
请输入评论内容...
请输入评论/评论长度6~500个字
暂无评论
暂无评论