先进封装
-
【聚焦】2.5D封装是先进封装技术 我国及全球布局企业不断增多
2.5D封装可以满足芯片高集成度、高性能、小尺寸、低功耗发展需求,在推动半导体产业技术升级方面扮演重要角色,在全球范围内应用比例快速攀升 2.5D封装,是一种先进封装技术,将多个芯片并排堆叠,利用中介层连接芯片,高密度布线实现电气连接,集成封装为一个整体
-

芯德半导体QMS项目正式启动,格创东智加速先进智造质量革命
近日,格创东智完成芯德半导体QMS项目需求调研,正式启动项目交付。通过近一个月时间的需求摸排,格创东智基于客户亟需解决的原QMS系统使用繁杂、功能延展弱、与实际业务符合性不高等主要瓶颈,定制化出基于契合客户业务现状的产品全生命周期QMS系统,因地制宜改善客户QMS系统现状
-

格创东智获锐杰微「卓越CIM系统供应商」,打造先进封装智能工厂
近日,格创东智荣获锐杰微科技集团(以下简称“锐杰微”)授予的卓越CIM系统供应商。自2024年12月起,格创东智助力锐杰微成功上线CIM系统,实现了生产效率和产品质量的显著提升。得益于CIM系统在整合
-

-
Melexis推出性能先进的温度传感器,以红外技术创新实现电磁炉智能温控
2025年01月20日,比利时泰森德洛——全球微电子工程公司Melexis宣布,推出专为电磁炉设计的非接触式红外温度传感器芯片MLX90617。该芯片运用创新的光学滤波技术,能够穿透电磁炉陶瓷面板,精准测量烹饪容器底部的温度
Melexis 2025-01-20 -

半导体先进封装:硅通孔技术的发展
芝能智芯出品 硅通孔(Through-Silicon Via, TSV)技术是一种用于实现芯片和晶圆垂直互联的关键工艺,被广泛应用于2.5D和3D封装中。 TSV通过缩短互连长度、降低功耗和信号延迟,大幅提升系统性能和整合度,当然TSV的高成本、复杂工艺及热应力管理等挑战限制了其大规模应用
-
Allegro MicroSystems重新定义传感技术,推出全新紧凑型封装电流传感器IC
新罕布什尔州曼彻斯特,美国,2025年1月8日 – 全球领先的运动控制、节能系统电源及传感解决方案供应商Allegro MicroSystems, Inc.(纳斯达克股票代码:ALGM;以
-

技术分析|英伟达的Thor芯片有多先进?
芝能智芯出品 进入2025年,进入端对端一段式模型下,汽车企业认识到高算力芯片的需求已成为推动行业进步的关键因素。英伟达于2022年推出的Thor芯片被誉为智能驾驶领域的新标杆,技术性能和设计理念为汽车行业带来了新的可能性
-

-

先进封装技术:如何解决应变与应力?
芝能智芯出品 先进封装技术正成为芯片制造产业的关键驱动力。台积电、三星和英特尔不仅在芯片制造中占据主导地位,也在先进封装领域引领潮流。 在台积电的3D Fabric技术体系中,包括InFO、CoW
-
韩国:大面积半导体封装技术取得进展
芝能智芯出品 随着半导体技术的快速演进,先进封装逐渐成为摩尔定律延续的重要推动力之一,大面积半导体封装技术以其提升生产效率、降低成本的优势,正吸引全球产业界的关注。 近期,韩国机械材料研究院(KI
-
封杀一切先进技术!美国正式将这140家中国半导体公司列入实体清单
快科技12月3日消息,据国外媒体报道称,美国工业和安全局 (BIS) 正式修订了《出口管理条例》(EAR),将 140个中国半导体行业相关实体添加到“实体清单”。 报道中提到
-
台积电欲在2025年后将先进2nm制造转移美国!
11月29日消息,据最新消息显示,台积电可能或在2025年后将先进2nm制造转移美国。 中国台湾科学技术部门官员吴诚文表示,台积电2nm制程将于明年量产,这时候台积电应已开始新一代制程的研发,就可以跟台积电讨论,是否要在友好地区投资2nm
-
台积电2027年推出9个掩模尺寸的超大版CoWoS封装
本文由半导体产业纵横(ID:ICVIEWS)综合 市场还关注台积电2nm是否可能提前赴美生产。 台积电11月欧洲开放创新平台(OIP)论坛上宣布,该公司有望在2027年认证其超大版本的CoWoS(晶圆上芯片)封装技术,该技术将提供高达9个掩模尺寸的中介层尺寸和12个HBM4内存堆栈
-
面板级封装FOPLP:下一个风口
芝能智芯出品 扇出型面板级封装(FOPLP)正在成为半导体封装领域的新宠。凭借其在成本效率、可扩展性以及高密度集成方面的潜力,FOPLP 从传统的消费电子和物联网应用向先进节点逐步扩展,试图挑战现有技术的主导地位,FOPLP 在大规模应用中仍面临材料兼容性、设备投资和标准化不足等问题
-
【聚焦】镀钯铜线技术水平不断提升 主要应用于高端集成电路封装领域
镀钯铜线可用作高端集成电路封装用键合线,为半导体制造环节核心材料。随着全球半导体产业向我国大陆转移,我国集成电路产量持续增长。 镀钯铜线,又称镀钯铜丝,指以金属铜为基材,外层镀有金属钯的特殊电线。镀
-
Allegro MicroSystems在德国慕尼黑电子展上推出先进的磁性和电感式位置感测解决方案
美国新罕布什尔州曼彻斯特 - 运动控制和节能系统传感技术和功率半导体解决方案的全球领导厂商Allegro MicroSystems(纳斯达克股票代码:ALGM)(以下简称Allegro)在 Electronica 2024上推出了新型电感式位置传感器和一系列微功率磁性开关和锁存器
-

工信部:提高先进功率半导体、智能传感器等关键核心部件供给能力
本文由半导体产业纵横(ID:ICVIEWS)转载自中华人民共和国工业和信息化部 《行动方案》明确,到2027年,我国新型储能制造业全链条国际竞争优势凸显。 11月6日,工信部发布《新型储能制造
-

NVIDIA、微软、谷歌等抢破头!台积电CoWoS封装要涨价20%
快科技11月3日消息,据摩根士丹利的最新报告,台积电正考虑对其3nm制程和CoWoS先进封装工艺提价,以应对市场需求的激增。 台积电计划在2025年实施涨价,预计3nm制程价格将上涨高达5%,而CoWoS封装价格可能上涨10%至20%
-

-

业绩暴雷!ASML股价继续大跌:想卖先进光刻机给中国厂商 但不被允许
快科技10月17日消息,由于业绩暴雷,这导致光刻机龙头ASML股价暴跌,而两天时间股价已跌超20%。 据官方公布的数据看,阿斯麦(ASML)今年第三季度接到的订单大幅减少,总订单金额约为26亿欧元,不到上一季度近56亿欧元的一半
-

-

直击封测年会,格创东智分享先进封装CIM国产方案
近日,作为集成电路产业发展风向标的第二十二届中国半导体封测技术与市场年会-第六届无锡太湖创芯论坛,在江苏无锡顺利召开,会议围炉共话先进封装技术、工艺、设备、关键材料、创新与投资等热点话题,为观众带来一次思想盛宴
-
HaleyTek 与BlackBerry QNX推出先进的座舱软件平台,引领软件定义音频的未来
2024年9月4日,加拿大,滑铁卢 — 今日,HaleyTek AB与BlackBerry(纽约证券交易
-

泰克先进半导体实验室:量芯微1200V氮化镓器件的突破性测试
_____ 在泰克先进半导体开放实验室,2024年8月份,我们有幸见证了量芯微(GaN Power)新一代1200V氮化镓(GaN)功率器件的动态参数测试。量芯微作为全球首家成功流片并
泰克先进半导体实验室 2024-09-03 -

电源模块封装技术,大势来袭!
前言: 近期,随着人工智能大模型和汽车行业的高速发展,算力需求急剧上升。 在此背景下,每提升一点算力,都需要相应增加电源设施的配备,这使得电源模块在数据中心和车载领域成为了不可或缺的核心组件。 这一趋势促使了模拟厂商们纷纷加大投入,竞相研发创新技术,以满足市场需求
-
【深度】AMB陶瓷基板在先进半导体封装领域需求旺盛 活性金属钎焊技术为其核心制备技术
活性金属钎焊技术具有技术成熟度高、成品质量好等优势,目前我国已有多家陶瓷基板企业掌握该项技术,这将为AMB陶瓷基板行业发展提供有利条件。 AMB陶瓷基板全称为活性金属钎焊陶瓷基板,指通过活性金属钎焊技术制作而成的高性能电子封装材料
-

看准先进封装海量需求,代工巨头组建联盟
前言: 在半导体市场中,台积电和三星是唯二实现市场份额季度增长的公司。 其中,台积电的市场占有率上升了2%;而三星的晶圆代工业务以14%的市场份额稳固了其第二大参与者的地位,较第三季度的13%有所增长
-

尺寸减小28%,罗姆面向xEV逆变器推出“二合一”SiC封装模块
碳化硅(SiC)作为一种宽禁带半导体材料,在高功率、高电压、高频率的应用场景下具有显著优势,其在xEV(包括纯电动汽车BEV和插电式混合动力汽车PHEV)上的应用规模快速增长。根据Yole Intel
-

缓解AI芯片产能压力,新的封装技术将崛起?
前言: 在半导体制造领域,台积电一直是技术革新的引领者。 近日,这家全球知名的芯片制造商正在积极探索一种全新的芯片封装技术,即从传统的晶圆级封装转向面板级封装,这将可能带来封装效率的显著提升和成本的降低
-
莱迪思推出全新安全控制FPGA系列产品,具备先进的加密敏捷性和硬件可信根
中国上海——2024年6月27日——莱迪思半导体(NASDAQ:LSCC),低功耗可编程器件的领先供应商,今日宣布推出两款全新解决方案,进一步巩固其在安全硬件和软件领域的领先地位,帮助客户应对系统安全领域日益严峻的挑战
莱迪思半导体 2024-06-27 -
【聚焦】MIS封装基板(MIS载板)封装中端芯片具有优势 相关布局企业数量较多
MIS封装基板具有布线细、电气连接性能优、尺寸小、散热性好、可靠性高等优点,可实现多芯片封装、超薄芯片封装、倒装芯片封装、高密度封装等,能够提高芯片设计的灵活性。 MIS封装基板,也称MIS
-

小型封装内置第4代SiC MOSFET,实现业界超高功率密度,助力xEV逆变器实现小型化!
全球知名半导体制造商ROHM(总部位于日本京都市)面向300kW以下的xEV(电动汽车)用牵引逆变器,开发出二合一SiC封装型模块“TRCDRIVE pack™”,共4款产品(750V 2个型号:BSTxxxD08P4A1x4,1
ROHM 2024-06-12 -

Qorvo? 推出采用 TOLL封装的750V4mΩ SiC JFET,推动断路器技术的革命性变革
中国 北京,2024 年 6 月 12 日——全球领先的连接和电源解决方案供应商 Qorvo®(纳斯达克代
Qorvo 2024-06-12 -
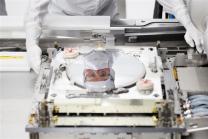
美国芯片管控引ASML吐槽:倒逼中国厂商造出更先进光刻机
快科技6月7日消息,近日,ASML公司CEO公开表示,美国严厉的芯片管控规定,只会倒逼中国厂商进步更快。 ASML CEO表示,多年来,公司都不用担心设备的去向会受到政治限制,但突然之间,这却变成了全世界最重要的话题之一
-

2024年中国先进封装行业研究报告
第一章 行业概况 1.1 简介 封装技术是半导体制造过程中的关键环节,旨在保护芯片免受物理和化学损害,同时确保芯片与其他电子元件的有效连接。随着技术的发展,封装技术可以分为传统封装和先进封装两大类,二者在工艺、应用和性能上各有特点
-

-

-

最新活动更多 >
-
3月19-20日立即报名>> 【线下会议】OFweek 2025 工商业储能大会
-
3月19-20日立即报名>> 【线下会议】OFweek 2025(第五届)储能技术与应用高峰论坛
-
3月19-20日立即报名>> OFweek 2025新能源产业协同发展大会
-
3月19-20日抢先报名>> OFweek 2025(第九届)动力电池产业年会
-
参编单位征集中立即参编>> 2025锂电市场格局及未来研判蓝皮书
-
即日-3.21立即报名 >> 【深圳 IEAE】2025 消费新场景创新与实践论坛







