沉锡板工艺
-

华虹半导体Q4亏损,向小工艺节点迈进存挑战
国产晶圆代工厂华虹半导体(01347.HK;688347.SH)在2024年出现营利双降的情况,公司在Q4净利更是出现亏损,出现近3年来首次单季度亏损。 证券之星注意到,公司毛利率受平均售价下降和折旧成本上升的双重压力的影响,毛利率大幅下滑
-

三星的最后一搏:2nm芯片工艺,自己先用,自己来证明
众所周知,不管实际情况如何,至少在表面上,三星是全球唯一能够,在先进芯片工艺上与台积电pk的厂商。 三星也是全球唯二拥有3nm芯片技术的厂商,另外一家是台积电。 甚至从量产时间上来看,三星的3nm
-
新微半导体宣布推出650V E-mode氮化镓功率工艺代工平台
3月10日,上海新微半导体有限公司(简称“新微半导体”)正式推出650V硅基氮化镓增强型(E-mode)功率工艺代工平台。该平台凭借高频运行效率、超低栅极电荷及低导通电阻等卓越特性,为新一代高速、高效功率器件应用提供了优异的解决方案
新微半导体 2025-03-11 -

GaAs芯片的表面工艺异常问题
一、砷化镓表面存在氧化层GaAs属于闪锌矿结构,具有立方晶系Fm3m空间群,晶胞参数为5.646 。Ga原子位于晶胞的顶点,As原子位于晶胞的面心和体内,形成四面体结构。GaAs表面在空气中容易发生氧化反应,生成氧化物如Ga2O3、As2O3和As2O5
GaAs芯片 2025-02-27 -

歌尔光学亮相SPIE 光波导刻蚀工艺新品首秀
近日,国际知名XR盛会SPIE AR|VR|MR在美国旧金山落下帷幕。SPIE AR|VR|MR是由SPIE(国际光学工程学会)举办的知名XR行业盛会,现已连续举办十届,活动聚焦于VR/AR硬件上游,
歌尔光学 2025-02-06 -

台积电供应商登陆科创板
文:诗与星空ID:SingingUnderStars 最近,台积电的美国亚利桑那州工厂宣布开始试产4nm芯片,进入验证阶段。这标志着经过连续的延期,“美积电”终于迎来了重大节点
-

冲关科创板 “幸运儿”恒坤新材实力咋样
独立 稀缺 穿透价值自证进行时作者:可乐编辑:闻道风品:小米来源:铑财——铑财研究院守好准入门槛,宁缺毋滥。回望2024年,上交所累计受理五家科创板项目,最后一个是恒坤新材,其也是12月受理“独苗”,可谓吸足眼球
-
半导体工艺进步如何从量变到质变?
芝能智芯出品 2024 年的国际电子设备会议(IEDM)再次展示了半导体行业的技术进步,尤其是 2nm CMOS 工艺、3D 堆叠技术及其在 AI 和高性能计算中的应用,预示着未来几年的重要趋势。 这些技术突破不仅推动了摩尔定律的延续,也促使封装、互连、晶体管和功率传输等领域发生了深刻的变革
-
小米15 Ultra超强性能全曝光:影像安卓手机天花板!
文|明美无限 前两个月小米发布了全新小米15和小米15 Pro,按照产品更新节奏来看,2025年第一季度预计将带来小米15 Ultra,最近关于15 Ultra的爆料多了起来,今天又有新消息。 这不近日,有媒体发现,小米15 Ultra系列已于2024年12月4日获3C认证
小米15Ultra 2024-12-16 -
台积电A16工艺将于2026年量产
本文由半导体产业纵横(ID:ICVIEWS)综合 台积电表示,先进工艺的开发正按路线图推进,未来几年基本保持不变。 近日,台积电在其欧洲开放创新平台论坛上宣布,计划在2025年末开始大规模量产N2工艺,A16(1.6nm级)工艺则预计在2026年末投产
-

村田开发兼顾伸缩性和可靠性的“可伸缩电路板”
主要特点 伸缩性:薄、柔软且伸缩性好的材料,给被测人员带来的不适感和负担也较轻 可靠性:依靠特有的电路板设计,实现了高绝缘性和可靠性 定制性:可根据所需规格检测多种项目
村田 2024-10-30 -

采用高压bipolar工艺制程的耐高压双极锁存霍尔芯片-AH401F
工采网代理的霍尔芯片 - AH401F是一款采用高压bipolar工艺制程的国产双极霍尔开关芯片;性能卓越具备耐高压、抗噪能力强等特点;能够承受高电压冲击,适用于各种恶劣环境。同时,极强的抗干扰能力,能够有效地抵御外部干扰,确保信号的准确性和可靠性
-
【洞察】中国PCB多层板低端领域同质性高 行业整体饱和度低
技术的创新与经验的积累如同双轮驱动,共同推动着PCB多层板制造企业不断突破技术壁垒,满足市场日益多样化的需求。 PCB多层板是有四层及以上导电图形的PCB,内层由导电图形与绝缘材料压制而成,外层为铜箔,层间导电图形通过导孔进行互连,可用在复杂电路中
PCB多层板 2024-10-18 -

【Molex】新品速递丨ZN Stack 0.50毫米端子间距浮动式板对板连接器
ZN Stack浮动式连接器为汽车电子设计带来了革命性的变革,该连接器专为可靠的车载数据处理与配电系统而设计,以满足行业对此类解决方案不断增长的需求。这些经过汽车验证的高速连接器能够在紧凑的布局中支持高达32 Gbps的数据传输速率,并确保与设备的无缝集成,提供设计灵活性和强大的大电流电源端子选项
-

苹果用2代芯片证明,3nm噱头居多,芯片工艺达极限了
苹果的iPhone16发布了,这次苹果带来了两颗3nm的芯片,分别是A18、A18 Pro,这是全球首颗 第二代3nm工艺的芯片。 而去年苹果发布的A17 Pro,则是全球首颗第一代3nm的芯片,后来联发科、高通都没有使用3nm工艺,可以说目前全球所有的3nm手机芯片,全部是苹果的
-

大联大世平集团推出基于NXP产品的HVBMS BJB评估板方案
2024年9月10日,致力于亚太地区市场的国际领先半导体元器件分销商---大联大控股宣布,其旗下世平推出基于恩智浦(NXP)MC33772C锂离子电池控制器IC的HVBMS BJB(高压电池管理系统电池接线盒)评估板方案
大联大世平集团 2024-09-10 -

-

摘要:使用SEMulator3D?可视性沉积和刻蚀功能研究金属线制造工艺,实现电阻的大幅降低
作者:泛林集团 Semiverse Solutions 部门软件应用工程师 Timothy Yang 博士 01 介绍 铜的电阻率由其晶体结构、空隙体积、晶界和材料界面失配决定,并随尺寸缩小而显著提升
泛林集团 2024-08-15 -

研华推出OSM Size-L核心板ROM-2860 搭载高通QCS6490赋能边缘AI应用
AIoT全球厂商研华隆重推出开放标准模块 (OSM) 新突破——ROM-2860核心板。ROM-2860采用LGA封装方式,实现45 x 45毫米超紧凑的尺寸设计。小尺寸但性能不凡,其搭载高通八核QCS6490处理器,达到了新的性能高度,为AIoT便携式应用带来突破
研华 2024-07-29 -

-
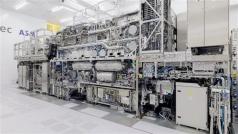
可量产0.2nm工艺!ASML公布超级EUV光刻机:但死胡同也不远了
ASML去年底向Intel交付了全球第一台High NA EUV极紫外光刻机,同时正在研究更强大的Hyper NA EUV光刻机,预计可将半导体工艺推进到0.2nm左右,也就是2埃米。 ASML
-
【聚焦】MIS封装基板(MIS载板)封装中端芯片具有优势 相关布局企业数量较多
MIS封装基板具有布线细、电气连接性能优、尺寸小、散热性好、可靠性高等优点,可实现多芯片封装、超薄芯片封装、倒装芯片封装、高密度封装等,能够提高芯片设计的灵活性。 MIS封装基板,也称MIS
-

超越尺寸限制:ROM-2820 OSM超小型核心板迎接HMI创新潮流
导言:在快速演进的人机界面(HMI)应用市场环境中,随着技术不断革新和成本控制要求的提高,对设备尺寸和定制化的需求日益增长。特别是在医疗,工业自动化等领域,客户对小型化、高性能以及高度定制化的解决方案的追求从未停止
研华 2024-05-28 -
可定制变压器采用独特的绕线结构和制造工艺,符合MIL-STD-981 S级标准
美国 宾夕法尼亚 MALVERN、中国 上海 — 2024年5月13日 — 日前,威世科技Vishay Intertechnology
Vishay 2024-05-13 -

-

-

-
Kanthal康泰尔创新工业电加热Globar SiC元件,为延长玻璃浮法锡槽寿命带来革命性突破
自20世纪50年代起,浮法工艺使玻璃制造业在平板玻璃的平滑度方面取得了越来越高的成就。为适应当今科技快速发展和市场需求多元化的挑战,浮法玻璃制造业正在面临新一轮的行业变革。如何进一步提高浮法锡槽的质量,优化其加热性能和使用寿命成为行业革新的关键
Kanthal 2024-04-28 -
芬兰伐德鲁斯Vahterus亮相中国制冷展,原创板壳式换热器展现技术新高度!
近来,第三十五届中国制冷展(CRH 2024)于中国国际展览中心(北京)成功举办。作为一家专注原创板壳式换热器的制造商,芬兰伐德鲁斯Vahterus携旗下两款原创板壳式换热器亮相,吸引了众多行业内外人士的目光
Vahterus 2024-04-19 -

通过工艺建模进行后段制程金属方案分析
作者:泛林集团 Semiverse Solutions 部门半导体工艺与整合部高级经理 Daebin Yim 由于阻挡层相对尺寸及电阻率增加问题,半导体行业正在寻找替代铜的金属线材料
泛林集团 2024-04-08 -

-
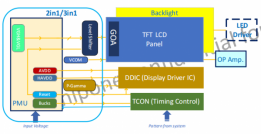
液晶显示逻辑板_TOCN板简介及驱动显示解决方案
TCON(时序控制电路)又称:逻辑板,屏幕驱动板;是一种用于驱动液晶显示屏的电路板;集成了各种功能的控制IC;是相关显示面板控制和画质提升的重要组成部分;同时也为gate和source提供驱动信号,通过COF连接到液晶面板实现显示
-

-

谷歌Tensor G4采用三星FOWLP封装,与三星 Exynos 2400相同工艺
(本篇文篇章共825字,阅读时间约1分钟) 谷歌即将推出的 Tensor G4 芯片备受关注,最新消息显示,该芯片将采用三星的 FOWLP 封装工艺,与三星 Exynos 2400 具有相同的技术特点
-

AMD未来APU露真容:3nm工艺与Zen6架构携手打造 Sound Wave
(本篇文篇章共636字,阅读时间约1分钟) AMD在不懈推进新产品的同时,近日首次公布了未来APU的代号——"Sound Wave"(声波)
-

-




